MOS集成電路電過(guò)應力損傷解析-KIA MOS管
信息來(lái)源:本站 日期:2021-01-25
電過(guò)應力(EOS)是MOS集成電路失效分析過(guò)程中常見(jiàn)失效原因,電過(guò)應力損傷對MOS集成電路可靠性危害很大,輕者導致電路電性能下降,留下隱患,影響電路的長(cháng)期可靠性,重者則可使MOS電路燒毀。因此在國際上是可靠性研究中的一個(gè)重要研究課題,受到人們的普遍重視。
電過(guò)應力損傷的原因
MOS電路的損壞及其功能的失效,大都由于電路引線(xiàn)上的高電壓或高功率密度引起的。一個(gè)較小的缺陷(如:一個(gè)漏電路徑)在電路工作時(shí)可能導致流過(guò)超過(guò)所能允許的電流而引起集成電路的嚴重損壞。
另外,錯誤的電行為和電路本身的缺陷一樣,也能導致電路的損傷或失效。產(chǎn)生電過(guò)應力的原因大,致可以分為三類(lèi):
(1) 靜電放電(ESD);(2)在工作過(guò)程中由于電源電壓或輸入信號的尖峰引起的過(guò)載; (3) 由于電荷載流子的注入引起的寄生成份的激發(fā)(如寄生雙極晶體管、四層結構、Latch--up 等)。
靜電放電從屬于電過(guò)應力范疇,它對半導體集成電路,特別是對MOS集成電路的危害、早為人們所關(guān)注。靜電放電的方式有三種:
(1)人體模型(HBM),如圖1所示。(2)機械模型(MM),如圖2所示。(3)充電器件模型(CDM),見(jiàn)圖3。第(2)和第(3)兩種靜電放電模型的特點(diǎn)是由低電阻引起的瞬間高壓脈沖,圖4所示。
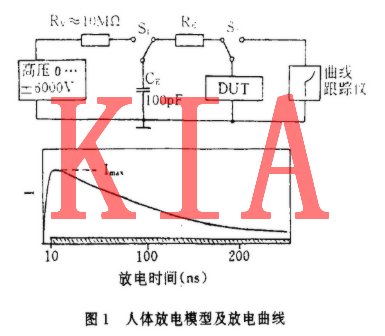
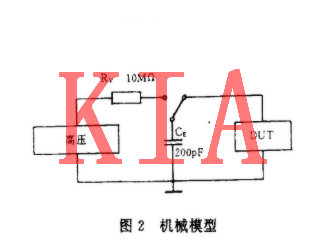


EOS損傷的模式和機理
(1)柵氧化層的損壞
①場(chǎng)引入邊緣的電擊穿(Flashover)
與帶電器件模型和機械模型相對應的ESD將產(chǎn)生這種場(chǎng)引入邊緣電擊穿的損傷模式。其特點(diǎn)是短時(shí)間的高壓脈沖放電,脈沖持續時(shí)間約0.1ns。這種損傷的位置一般在輸入保護結構或與輸入相連的柵氧化層邊緣和襯底之間,尺寸在0.1~ 1μm之間。
②由溫度引入 的二次電擊穿
對于人體模型的靜電放電,在低的靜電電壓下,較長(cháng)時(shí)間的電過(guò)應力將產(chǎn)生二次電過(guò)沖,由于電壓較低,故不能產(chǎn)生場(chǎng)引入柵氧化層電擊穿,而是pn結的熱擊穿和柵下溝道的溫升,從而導致柵上的柵氧化層介質(zhì)強度減弱。這時(shí)所加電壓足以引起場(chǎng)引入的柵氧化層的電擊穿,我們稱(chēng)之為“二次效應”。
二次效應的癥狀表現為襯底中晶格結構的損傷和在柵氧化層邊緣的電擊穿。位置一般在輸入保護結構和輸出驅動(dòng)器上。
pn結的輕微熱損傷
pn結的輕微熱損傷是由于人體模型的ESD或EOS引起的,損傷位置一般在輸入和輸出附近或與Vss和Vdd內連的擴散區附近。
(1)結的熱擊穿
當反向電壓超過(guò)規定值時(shí),就有一個(gè)反向電流流過(guò)pn結,損耗的功率導致熱斑。所產(chǎn)生的溫度高低將決定電路的命運。
(2)結的退化
溫度太低不會(huì )形成熔化的溝道,但會(huì )使晶格結構和摻雜側面產(chǎn)生損傷,這就導致了極高電阻的pn結漏電(典型值1MΩ)。
(3)接觸孔的熱-電遷移,并在Si上形成熔化的溝道
熱擊穿以后,通過(guò)附加的能量在Si中pn結上方形成一個(gè)熔化的溝道,結果形成了一條通向鄰近屬于導電多晶硅下的擴散區(典型值10kΩ),見(jiàn)圖6。
(4)在溶化的溝道中帶有一座金耦橋的電-熱遷移
當附加更大能量時(shí),熔化的AI流進(jìn)溶化溝道,并填充之;凝固后導電的橋就具有阻值0.1~1kΩ。見(jiàn)圖7所示。

(5)在接觸孔處尖峰的形成
在熱擊穿的情況下(或在正常工作期間),若無(wú)Si的溶化,結的長(cháng)期過(guò)應力將引起AI尖峰的產(chǎn)生。
a)沒(méi)有滲透至pn結的尖峰將導致一個(gè)4層結構(pnpn結構),這就要引起pnpn結構電行為的燒毀,見(jiàn)圖8。
b)滲透到pn結的尖峰將產(chǎn)生一個(gè)通過(guò)pn結的低阻橋,并進(jìn)一步加深熱-電遷移,見(jiàn)圖9。

EOS對金屬引線(xiàn)和電阻器的損傷
人體模型的靜電放電和工作中的電過(guò)應力時(shí)常伴隨著(zhù)大電流流過(guò)。這將損傷金屬引線(xiàn)和電阻器。位置一般在集成電路的輸入保護結構上。
電過(guò)應力引起的徹底破壞
集成電路在工作期間,當電路上存在微小缺陷或寄生結構受外來(lái)因素的激發(fā)(雙極晶體管四層結構、Latch-up等)時(shí),電路將有大電流流過(guò),便會(huì )導致集成電路的徹底破壞。
其癥狀表現在接觸孔、擴散區的損壞和金屬化通道的燒毀;鍵合金絲的溶化;封裝部分和燒焦等。
聯(lián)系方式:鄒先生
聯(lián)系電話(huà):0755-83888366-8022
手機:18123972950
QQ:2880195519
聯(lián)系地址:深圳市福田區車(chē)公廟天安數碼城天吉大廈CD座5C1
請搜微信公眾號:“KIA半導體”或掃一掃下圖“關(guān)注”官方微信公眾號
請“關(guān)注”官方微信公眾號:提供 MOS管 技術(shù)幫助

