元器件封裝圖文詳解及作用、分類(lèi)-KIA MOS管
信息來(lái)源:本站 日期:2021-05-11
元器件封裝,就是指把硅片上的電路管腳,用導線(xiàn)接引到外部接頭處,以便與其它器件連接·封裝形式是指安裝半導體集成電路芯片用的外殼。
它不僅起著(zhù)安裝、固定、密封、保護芯片及增強電熱性能等方面的作用,而且還通過(guò)芯片上的接點(diǎn)用導線(xiàn)連接到封裝外殼的引腳上,這些引腳又通過(guò)印刷電路板上的導線(xiàn)與其他器件相連接,從而實(shí)現內部芯片與外部電路的連接。
因為芯片必須與外界隔離,以防止空氣中的雜質(zhì)對芯片電路的腐蝕而造成電氣性能下降。另一方面,封裝后的芯片也更便于安裝和運輸。
元器件封裝形式是半導體器件的一種封裝形式。SMT所涉及的零件種類(lèi)繁多,樣式各異,有許多已經(jīng)形成了業(yè)界通用的標準,這主要是一些芯片電容電阻等等;有許多仍在經(jīng)歷著(zhù)不斷的變化,尤其是 IC 類(lèi)零件,其封裝形式的變化層出不窮。
封裝形式一
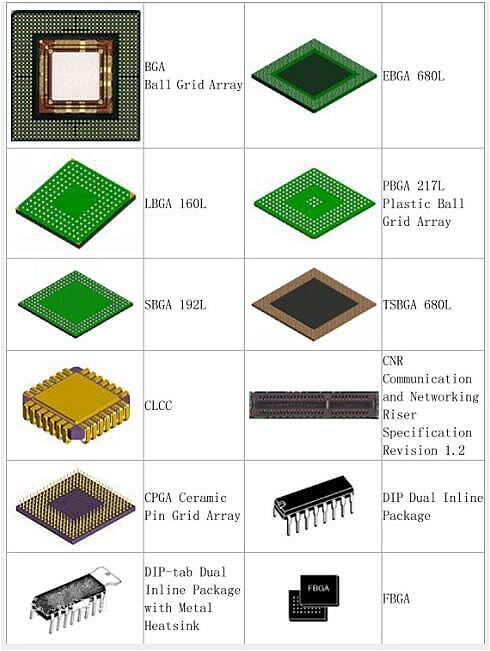
封裝形式二

封裝形式三
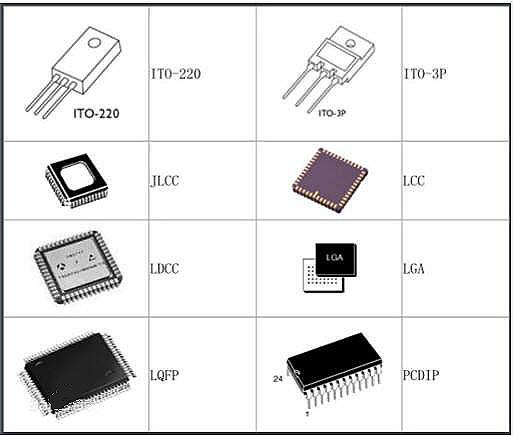
封裝形式四
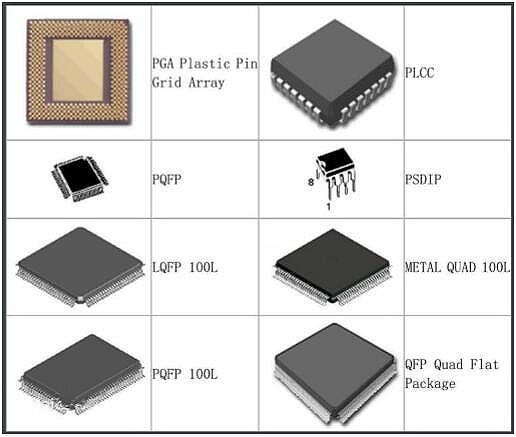
封裝形式五

封裝形式六
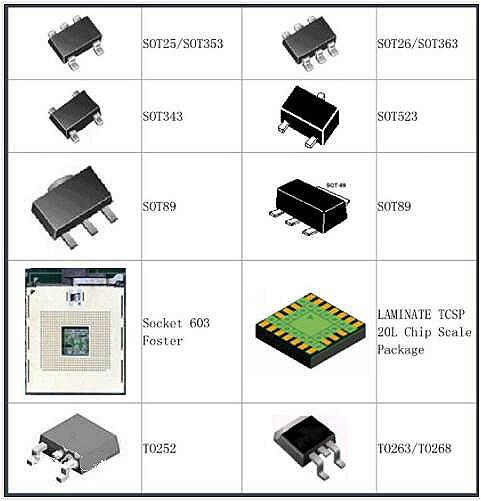
封裝(Package)對于芯片來(lái)說(shuō)是必須的,也是至關(guān)重要的。封裝也可以說(shuō)是指安裝半導體集成電路芯片用的外殼,它不僅起著(zhù)保護芯片和增強導熱性能的作用,而且還是溝通芯片內部世界與外部電路的橋梁和規格通用功能的作用。封裝的主要作用有:
(1)物理保護
因為芯片必須與外界隔離,以防止空氣中的雜質(zhì)對芯片電路的腐蝕而造成電氣性能下降,保護芯片表面以及連接引線(xiàn)等,使相當柔嫩的芯片在電氣或熱物理等方面免受外力損害及外部環(huán)境的影響;
同時(shí)通過(guò)封裝使芯片的熱膨脹系數與框架或基板的熱膨脹系數相匹配,這樣就能緩解由于熱等外部環(huán)境的變化而產(chǎn)生的應力以及由于芯片發(fā)熱而產(chǎn)生的應力,從而可防止芯片損壞失效。
基于散熱的要求,封裝越薄越好,當芯片功耗大于2W時(shí),在封裝上需要增加散熱片或熱沉片,以增強其散熱冷卻功能;5~1OW時(shí)必須采取強制冷卻手段。另一方面,封裝后的芯片也更便于安裝和運輸。
(2)電氣連接
封裝的尺寸調整(間距變換)功能可由芯片的極細引線(xiàn)間距,調整到實(shí)裝基板的尺寸間距,從而便于實(shí)裝操作。
例如從以亞微米(目前已達到0.1 3μm以下)為特征尺寸的芯片,到以10μm為單位的芯片焊點(diǎn),再到以100μm為單位的外部引腳,最后劍以毫米為單位的印刷電路板,都是通過(guò)封裝米實(shí)現的。
封裝在這里起著(zhù)由小到大、由難到易、由復雜到簡(jiǎn)單的變換作用,從而可使操作費用及材料費用降低,而且能提高工作效率和可靠性,特別是通過(guò)實(shí)現布線(xiàn)長(cháng)度和阻抗配比盡可能地降低連接電阻,寄生電容和電感來(lái)保證正確的信號波形和傳輸速度。
(3)標準規格化
規格通用功能是指封裝的尺寸、形狀、引腳數量、間距、長(cháng)度等有標準規格,既便于加工,又便于與印刷電路板相配合,相關(guān)的生產(chǎn)線(xiàn)及生產(chǎn)設備都具有通用性。這對于封裝用戶(hù)、電路板廠(chǎng)家、半導體廠(chǎng)家都很方便,而且便于標準化。
相比之下,裸芯片實(shí)裝及倒裝目前尚不具備這方面的優(yōu)勢。由于組裝技術(shù)的好壞還直接影響到芯片自身性能的發(fā)揮和與之連接的印刷電路板(PCB)的設計和制造,對于很多集成電路產(chǎn)品而言,組裝技術(shù)都是非常關(guān)鍵的一環(huán)。
半導體(包括集成電路和分立器件)其芯片的封裝已經(jīng)歷了好幾代的變遷,從DIP、SOP、QFP、PGA、BGA到MCP再到SIP,技術(shù)指標一代比一代先進(jìn),包括芯片面積與封裝面積之比越來(lái)越接近于1,適用頻率越來(lái)越高,耐溫性能越來(lái)越好,引腳數增多,引腳間距減小,重量減小,可靠性提高,使用更加方便等等。封裝(Package)可謂種類(lèi)繁多,而且每一種封裝都有其獨特的地方,即它的優(yōu)點(diǎn)和不足之處,當然其所用的封裝材料、封裝設備、封裝技術(shù)根據其需要而有所不同。
1、金屬封裝
金屬封裝始于三極管封裝,后慢慢地應用于直插式扁平式封裝,基本上乃是金屬-玻璃組裝工藝。
由于該種封裝尺寸嚴格、精度高、金屬零件便于大量生產(chǎn),故其價(jià)格低、性能優(yōu)良、封裝工藝容易靈活,被廣泛應用于晶體管和混合集成電路如振蕩器、放大器、鑒頻器、交直流轉換器、濾頗器、繼電器等等產(chǎn)品上,現在及將來(lái)許多微型封裝及多芯片模塊(MCM)也采用此金屬封裝。
金屬封裝的種類(lèi)有光電器件封裝包括帶光窗型、帶透鏡型和帶光纖型;分妒器件封裝包括A型、B型和C型;混合電路封裝包括雙列直插型和扁平型;特殊器件封裝包括矩正型、多層多窗型和無(wú)磁材料型。
2、陶瓷封裝
早期的半導體封裝多以陶瓷封裝為主,伴隨著(zhù)半導體器件的高度集成化和高速化的發(fā)展,電子設備的小型化和價(jià)格的降低,陶瓷封裝部分地被塑料封裝代替,但陶瓷封裝的許多用途仍具有不可替代的功能,特別是集成電路組件工作頻率的提高,信號傳送速度的加快和芯片功耗的增加,需要選擇低電阻率的布線(xiàn)導體材料,低介電常數,高導電率的絕緣材料等。陶瓷封裝的種類(lèi)有DIP和SIP;對大規模集成電路封裝包括PGA,PLCC,QFP和BGA。
3、金屬一陶瓷封裝
它是以傳統多層陶瓷工藝為基礎,以金屬和陶瓷材料為框架而發(fā)展起來(lái)的。最大特征是高頻特性好而噪音低而被用于微波功率器件,如微波毫米波二極管、微波低噪聲三極管、微波毫米波功率三極管。
正因如此,它對封裝體積大的電參數如有線(xiàn)電感、引線(xiàn)電阻、輸出電容、特性阻抗等要求苛刻,故其成品率比較低;同時(shí)它必須很好地解決多層陶瓷和金屬材料的不同膨脹系數問(wèn)題,這樣才能保證其可靠性。
金屬一陶瓷封裝的種類(lèi)有分立器件封裝包括同軸型和帶線(xiàn)型;單片微波集成電路(MMIC)封裝包括載體型、多層陶瓷型和金屬框架一陶瓷絕緣型。
4、塑料封裝
塑料封裝由于其成本低廉、工藝簡(jiǎn)單,并適于大批量生產(chǎn),因而具有極強的生命力,自誕生起發(fā)展得越來(lái)越快,在封裝中所占的份額越來(lái)越大。目前塑料封裝在全世界范圍內占集成電路市場(chǎng)的95%以上。
在消費類(lèi)電路和器件基本上是塑料封裝的天下;在工業(yè)類(lèi)電路中所占的比例也很大,其封裝形式種類(lèi)也是最多。塑料封裝的種類(lèi)有分立器件封裝,包括A型和F型;集成電路封裝包括SOP、DIP、QFP和BGA等。
按封裝密封性方式可分為氣密性封裝和樹(shù)脂封裝兩類(lèi)。他們的目的都是將晶體與外部溫度、濕度、空氣等環(huán)境隔絕,起保護和電氣絕緣作用;同時(shí)還可實(shí)現向外散熱及緩和應力。
其中氣密性封裝可靠性較高,但價(jià)格也高,目前由于封裝技術(shù)及材料的改進(jìn),樹(shù)脂封占絕對優(yōu)勢,只是在有些特殊領(lǐng)域,尤其是國家級用戶(hù)中,氣密性封裝是必不可少的。氣密性封裝所用到的外殼可以是金屬、陶瓷玻璃,而其中氣體可以是真空、氮氣及惰性氣體。
按封裝的外形、尺寸、結構分類(lèi)可分為引腳插入型、表面貼裝型和高級封裝。
1、插入式封裝
引腳插入式封裝(Through-Hole Mount)。此封裝形式有引腳出來(lái),并將引腳直接插入印刷電路板(PWB)中,再由浸錫法進(jìn)行波峰焊接,以實(shí)現電路連接和機械固定。
由于引腳直徑和間距都不能太細,故印刷電路板上的通孔直徑,間距乃至布線(xiàn)都不能太細,而且它只用到印刷電路板的一面,從而難以實(shí)現高密度封裝。它又可分為引腳在一端的封裝(Single ended),引腳在兩端的封裝(Double ended)禾口弓I勝9矩正封裝(Pin Grid Array)。
2、尺寸貼片封裝(SOP)
表面貼片封裝(Surface Mount)。它是從引腳直插式封裝發(fā)展而來(lái)的,主要優(yōu)點(diǎn)是降低了PCB電路板設計的難度,同時(shí)它也大大降低了其本身的尺寸。
我們需要將引腳插片封裝的集成電路插入PCB中,故需要在PCB中根據集成電路的引腳尺寸(FootPrint)做出專(zhuān)對應的小孔,這樣就可將集成電路主體部分放置在PCB板的一面,同時(shí)在PCB的另一面將集成電路的引腳焊接到PCB上以形成電路的連接,所以這就消耗了PCB板兩面的空間,而對多層的PCB板而言,需要在設計時(shí)在每一層將需要專(zhuān)孔的地方騰出。
而表面貼片封裝的集成電路只須將它放置在PCB板的一面,并在它的同一面進(jìn)行焊接,不需要專(zhuān)孔,這樣就降低了PCB電路板設計的難度。表面貼片封裝的主要優(yōu)點(diǎn)是降低其本身的尺寸,從而加大了PCB上IC的密集度。
用這種方法焊上去的芯片,如果不用專(zhuān)用工具是很難拆卸下來(lái)的。表面貼片封裝根據引腳所處的位置可分為:Single-ended(引腳在一面)、Dual(引腳在兩邊)、Quad(引腳在四邊)、Bottom(引腳在下面)、BGA(引腳排成矩正結構)及其它。
3、表面貼片QFP封裝
四邊引腳扁平封裝 (QFP:Plastic Quad Flat Pockage)。QFP是由SOP發(fā)展而來(lái),其外形呈扁平狀,引腳從四個(gè)側面引出呈海鷗翼(L)型,如圖4所示。鳥(niǎo)翼形引腳端子的一端由封裝本體引出,而另一端沿四邊布置在同一平面上。
它在印刷電路板(PWB)上不是靠引腳插入PWB的通孔中,所以不必在主板上打孔,而是采用SMT方式即通過(guò)焊料等貼附在PWB上,一般在主板表面上有設計好的相應管腳的焊點(diǎn),將封裝各腳對準相應的焊點(diǎn),即可實(shí)現與主板的焊接。
因此,PWB兩面可以形成不同的電路,采用整體回流焊等方式可使兩面上搭載的全部元器件一次鍵合完成,便于自動(dòng)化操作,實(shí)裝的可靠性也有保證。這是目前最普遍采用的封裝形成。用這種方法焊上去的芯片,如果不用專(zhuān)用工具是很難拆卸下來(lái)的。
4、表面貼片BGA封裝
球型矩正封裝(BGA:Ball Grid Array),見(jiàn)圖5。日本西鐵城(CitiZell)公司于1987年著(zhù)手研制塑料球型矩正封裝,而后摩托羅拉、康柏等公司也隨即加入到開(kāi)發(fā)BGA的行列。其后摩托羅拉率先將球型矩正封裝應用于移動(dòng)電話(huà),同年康柏公司也在工作站、個(gè)人計算機上加以應用,接著(zhù)Intel公司在計算機CPU中開(kāi)始使用BGA。
雖然日本公司首先研發(fā)球型矩正封裝,但當時(shí)日本的一些半導體公司想依靠其高超的操作技能固守QFP不放而對BGA的興趣不大,而美國公司對:BGA應用領(lǐng)域的擴展,對BGA的發(fā)展起到了推波助瀾的作用。BGA封裝經(jīng)過(guò)十幾年的發(fā)展已經(jīng)進(jìn)入實(shí)用化階段,目前BGA已成為最熱門(mén)封裝。
5、高級封裝
晶片級封裝CSP(Chip Scale Package)。幾年之前以上所有的封裝其封裝本體面積與芯片面積之比通常都是幾倍到幾十倍,但近幾年來(lái)有些公司在BGA、TSOP的基礎上加以改進(jìn)而使得封裝本體面積與芯片面積之比減小到接近1的水平,所以就在原來(lái)的封裝名稱(chēng)下冠以芯片級封裝以用來(lái)和以前封裝的區別。
就目前來(lái)看,人們對芯片級封裝還沒(méi)有一個(gè)統一的定義,有些公司將封裝本體面積與芯片面積之比小于2的定為CSP,而有些公司將封裝本體面積與芯片面積之比小于1.4或1.2的定為CSP。
目前開(kāi)發(fā)應用最為廣泛的是FBGA和QFN等,主要用于內存件和邏輯器件。就目前來(lái)看CSP的引腳數還不可能太多,從幾十到一百以上。這種高密度、小巧、扁薄的封裝非常適用于設計小巧的掌上型消費類(lèi)電子裝置,如個(gè)人信息工具、手機、攝錄一體機、以及數碼相機等。
聯(lián)系方式:鄒先生
聯(lián)系電話(huà):0755-83888366-8022
手機:18123972950
QQ:2880195519
聯(lián)系地址:深圳市福田區車(chē)公廟天安數碼城天吉大廈CD座5C1
請搜微信公眾號:“KIA半導體”或掃一掃下圖“關(guān)注”官方微信公眾號
請“關(guān)注”官方微信公眾號:提供 MOS管 技術(shù)幫助

